

Seit vielen Jahren forscht das PtU auf dem Gebiet der Oberflächentechnik und der Oberflächencharakterisierung. Im Rahmen dieser Forschungstätigkeit konnte 2010 in Kooperation mit der Firma Jeol ein neues Rasterelektronenmikroskop beschafft werden. Auf Grund der deutlich kürzeren Wellenlänge des Elektronenstrahls ist es möglich, mikroskopische Untersuchungen mit deutlich höheren Auflösungen als mit herkömmlichen Auflichtmikroskopen durchzuführen.
Mit den drei Aufnahmemodi Sekundärelektronenbild, Rückstreuelektronen Compo und Rückstreuelektronen Topo können Materialkontraste und Topographien in unterschiedlichen Intensitäten plastisch dargestellt werden. Die Untersuchung nichtleitender Stoffe wie Papier- oder Kohlefaserverbundwerkstoffe wird durch das Arbeiten im Niedervakuum möglich.


Neben den reinen mikroskopischen Aufnahmen kann mit diesem Messmittel die elementare Zusammensetzung der Probenkörper sowie die Oberflächentopographien in dreidimensionaler Form analysiert werden. Während der Interaktion des Elektronenstrahls mit der Oberfläche des Probenkörpers werden energiespezifische Röntgenstrahlen emittiert. Auf diese Weise können mittels der Energiedispensiven Röntgenspektralanalyse (EDX) Rückschlüsse auf die Zusammensetzung des Probenmaterials sowie der Oberflächenstrukturen gewonnen werden. Über die digitale Umwandlung von zweidimensionalen Oberflächenaufnahmen kann mit der Software der Firma Alicona die Oberflächentopographie dreidimensional Vermessen werden.
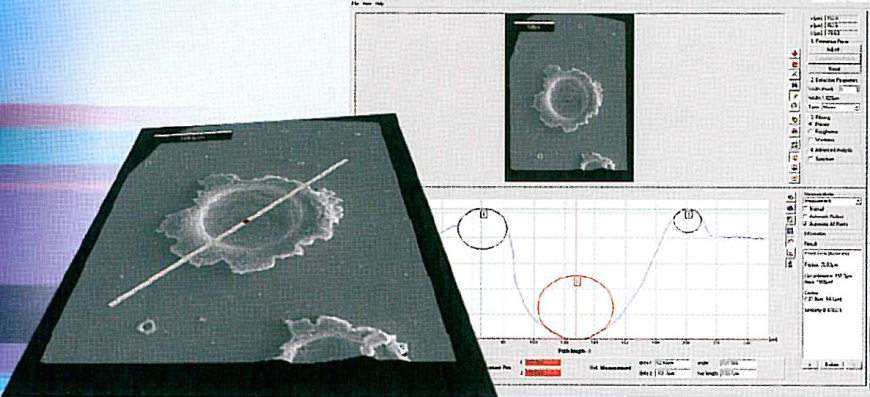
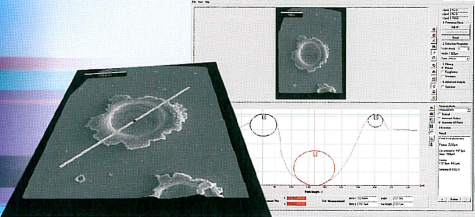
Technische Daten
- Vergrößerung: 5x – 300.000x
- Auflösung (SE): 3 nm (30 kV)
- Auflösung (LV): 4 nm (30 kV)
- Verfahrwege:
x = 120 mm
y = 100 mm
z = 80 mm
t = -10° – 90°
r = 360° endlos


